提供先进封装一体化技术解决方案,「鑫巨半导体」获近亿元A轮融资
36氪广东获悉,近日鑫巨(深圳)半导体科技有限公司(下称「鑫巨半导体」)获得近亿元A轮融资,本轮融资由国中资本领投,主要投资方包括中信创投等多家投资机构。本轮融资将主要用于先进封装所需的5~10微米级别的IC载板生产装备产业化,加速国内半导体先进制程装备技术的研发、团队扩充及市场化推进。
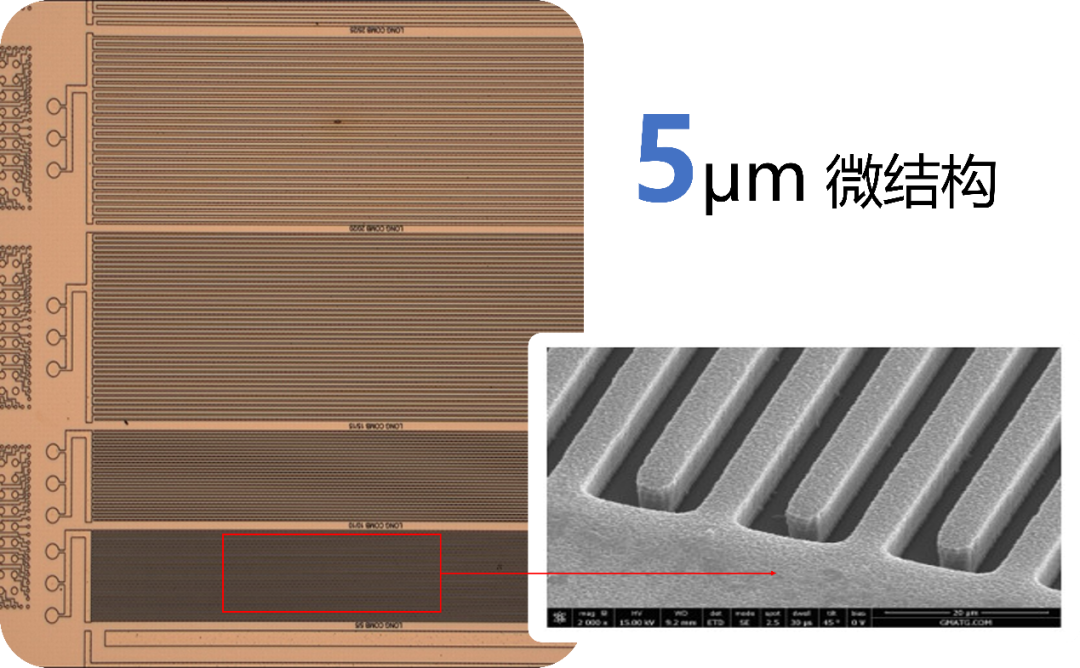
图片来源:鑫巨半导体
「鑫巨半导体」成立于2020年6月,是一家专注于研发和制造IC载板制造和先进封装所需的湿制程设备的高科技技术型企业,拥有优秀的设备制造能力和工艺制程技术,主要产品为高阶湿制程设备,主要面向的工艺制程为精密电镀和精密刻蚀及配套处理环节,可为下游客户提供“工艺+设备+材料”的一体化解决方案。

图片来源:鑫巨半导体
因在国内IC封装载板设备领域的稀缺性,成立仅3年时间,「鑫巨半导体」便于今年3月获入选2022年深圳市专精特新中小企业名单,2023年入选“深圳市未来行业领袖”50强,此前,还取得“国家高新技术企业”等称号,并被列入“深圳市重大项目计划”。

专注先进封装已获国内一线大额订单
在“摩尔定律”下,芯片集成的晶体管数量几乎是每两年翻一番,但受限于各种因素,硅级别的缩放正在变得越来越艰难,成本越来越高,因此,“摩尔极限”这个概念也正被越来越多人所熟知。
半导体行业迭代正在努力寻找新方向,先进封装技术就是其中一条重要路径。这是一条在制程不变的情况下,通过高速互联、3D结构等来实现系统性能突破的技术。“目前各个先进的海外终端IC公司都已将目光投向了以先进集成电路封装载板(ICS)为依托的先进封装方向。”「鑫巨半导体」创始人兼CEO陈琳如是称。
“随着半导体行业的飞速发展,硅基芯片面临的主要瓶颈出现在‘光刻极限’进入到纳米级,已经慢慢接近硅原子的直径,很难再进一步突破,等待下一次技术变革时间尚未明确。”杭州中科先进技术研究院副院长、中国科学院大学博士生导师范小朋表示。
他进一步指出:“因此,对于芯片产业发展而言,技术变革可能发生在两个方向。第一个是Chiplet和3D封装技术,通过提升芯片的集成度来进一步提升芯片性能,这个转变和高端封装技术升级有关,也是目前几大芯片制造企业共同努力的方向;第二个是硅光技术,通过改变芯片内部的通信和计算方式,从而改变芯片设计结构,但是这样做增加了设计和工艺难度。
“上述两个技术方向的变革都对芯片载板的设计和生产提出了新的要求,在此背景下「鑫巨半导体」应运而生,在国内可能成为稀缺的拥有高端载板生产设备核心创新技术的高科技企业,为高端载板生产设备走出一条中国道路。”
事实上,正是因为先进封装技术,让Chiplet、异构集成和裸片堆叠成为了可能,让开发者打造起更高良率的小芯片,同时根据需求为芯片选择相对应的制程,再集成到一起。因此,先进封装是国际主流发展的重点。
“于相关产业而言,因为现阶段全球都处于发展初始阶段,国内并没有被国外甩开太多身位。”陈琳表示,“在这一赛道,国内潜在市场巨大,同时海外市场的下游客户也面临着新阶段、新技术、新设备的更新换代需求,相应市场空间巨大。”
据悉,2020年成立的「鑫巨半导体」,在2021年完成设备设计及量产工程样机制造,2022年进入客户测试,2023年开始公司主要与客户进行产品研发和验证。
“公司目前已获得国内一线的半导体集成电路封装载板制造企业大额订单,并进入国内外多家载板制造厂商的设备采购名录,流片测试结果均超出客户预期,预计2024年公司订单将出现井喷式爆发。”陈琳称。

图片来源:鑫巨半导体

制造更适合客户所需的工艺支撑设备
据了解,「鑫巨半导体」的核心技术成果能够解决和突破我国在先进封装领域高端装备制造的“卡脖子”难题,可用于先进封装的2D、FO、2.xD、3D、PLP等先进系统集成封装及Chiplet制造,是半导体装备制造及工艺的底层技术研究。
杭州中科先进技术研究院副院长、中国科学院大学博士生导师范小朋表示:“「鑫巨半导体」关键性技术指标,包括线宽、线距以及良率等均已处于国际前列水平,在未来中国高端载板制造领域竖起了中国制造的旗帜,在全球高端载板的生产链和供应链占据了合适的关键性位置,在中国乃至世界半导体发展历史上将来必定占据一席之地。”
据介绍,「鑫巨半导体」核心团队由国际封装行业和IC基板设备制造领域的专家组成,技术团队拥有平均25年以上先进湿制程工艺设备相关技术开发能力,以及先进载板批量制造的工艺能力与技术经验,可以向下游客户交付一体化的技术解决方案。「鑫巨半导体」目前掌握国际先进、完全自主研发的5微米及以下线路芯片载板的工艺与制程设备技术,并已获得国内外相关专利。
对比同行根据设备厂已有或研发中的工艺、需求,仅提供定制化设备的传统解决方案,「鑫巨半导体」结合自身优势,提供“设备+工艺”的一体化解决方案,包括化学药物耗材方面的支持等。“这是我们与竞争对手最大的差异,这种方式也帮助客户解决很多繁重的工作,缩短测试和研发周期。”
简单举例,在先进封装项目中,比如增层(Lay-up)制造过程中一般会有100多个工序,而制造过程中,每道工序都会有一些特定材料。下游客户需要通过不断测试、实验方案,才能得出适配材料。“测试可能需要从药水选型、酸碱度设置、喷淋压力……多方面进行调试。”
而「鑫巨半导体」可以通过自身经验,为客户提供材料适配建议,甚至帮助客户测试和实验。“我们可以协助客户完成制程关键阶段的工艺参数的制定,匹配客户HVM生产条件下的高良率和高直通率产出需求。在我们的设备上能看到‘所见即所得’这一贯穿公司研发工作始终的观念。”陈琳表示,“主要关键点在于技术指标,比方说高密度纹路、盘中走线,所需的设定参数、药水、工艺控制细节。这些基于公司经验,可以很快形成成果交付给客户。”
目前,「鑫巨半导体」已完成了与下游客户的工艺及量产化打样工作,并完成了交付产品的具体规格参数对接。
走过了市场验证阶段,陈琳指出,后续公司会根据市场发展及情况逐步扩张公司整体规模,并通过融资使资金持续匹配公司发展进度。“发展规划一方面鉴于公司所处的主机厂地位,在未来国产零部件供应链开发的过程中也可以发挥独特的作用。另一方面,国际上也非常重视先进封装行业,譬如美国政府。根据美国近期公布的“国家先进封装制造计划”(NAPMP)——美国《芯片与科学法案》第一个研发投资项目计划,拟投入大约30亿美元(约合215亿元),专门用于资助美国的IC先进封装行业。而我司所处的技术领域正好是相关报告内容中的高密度封装基板和配套生产设备。
“随着公司发展,为更好服务全国各地客户,我们未来将增加新的工厂。具体的选址,我们会从人工成本、运输成本、生产成本以及下游客户需求等多个维度仔细考虑,来判断具体的设厂位置。”
对于未来发展策略,陈琳表示,公司将分为三个步骤:追赶、引领、保持。“追赶,是指在技术上追赶国际水平;引领,是在国际、国内,通过公司技术、工艺,使设备处于领先;保持,则是在整个行业里面保持技术优势。”

投资人说
国中资本投资团队表示:“后摩尔时代下的异构集成芯片技术Chiplet是满足当前爆炸式算力需求的重要赛道,因此抢占先进封装产业链及关键载板技术与装备是大国科技博弈的下一个重要战略高地。「鑫巨半导体」核心团队曾在国际头部载板厂从建设到量产的全过程担任核心角色,掌握载板上下游的多个环节,具有极强的专业技术能力与国际化背景。「鑫巨半导体」的湿制程工艺设备已突破5um线宽/线距载板的制造能力,未来将持续面向高端载板生产商,提供设备、工艺与材料的综合解决方案,解决先进封装技术核心部件‘卡脖子’现状。”























